Microscopi electrònic de transmissió
La idea d'utilitzar feixos d'electrons per a obtenir imatges ampliades va ser duta a terme en 1932 per dos grups d'investigadors de Berlín.

A més d'en Medicina i Biologia, la microscòpia electrònica es va utilitzar des dels seus inicis en la Recerca de Materials.
Alguns defectes estructurals fins llavors provats a nivell teòric o indirectament, van anar directament observats amb el microscopi electrònic. Des de llavors, encara que el volum de recerques realitzades amb el microscopi electrònic ha estat enorme a nivell de publicació, el volum de matèria analitzat amb el microscopi electrònic a tot el món és només de ¼ 1 mm3!
La raó d'aquesta fascinant dada radica en els enormes increments que es poden obtenir del Microscopi d'Electrons. Per a arribar a conclusions estadísticament significatives serà necessari, per tant, analitzar mostres suficients, ja que el volum de matèria és molt reduït per cada micrografía (foto al microscopi) (ª ?0,4 m³).
El microscopi electrònic de transmissió (T.E.M.) pot mostrar les característiques més importants de la microestructura tant en materials amorfs com cristal·lins. En aquests últims s'utilitza el fenomen de difracció d'electrons per a detectar l'estructura i orientació d'alguna característica (potser d'1 ?m de diàmetre) mitjançant imatges de difracció, o aprofitant el mateix procés de difracció per a obtenir una imatge contrastada real de dislocacions, defectes de congestió o petits precipitats.

Els electrons són els elements que formen la imatge en el microscopi d'electrons de transmissió, igual que en l'escàner.
El feix d'electrons es genera en la part superior de la columna situada en el buit, una vegada escalfat el filament de W o LaB6. El feix d'electrons s'accelera per una diferència de potencial entre 75 i 120 kV (o superior) per sota de la columna i es condensa per una lent condensadora eletromagnética fins a un diàmetre mínim de 3 a 5 ?m, passant posteriorment per una secció de la mostra col·locada en l'aplicador (veure part superior de la figura 1). La mostra explorada haurà de ser molt fina perquè els electrons la travessin.

Si l'objecte és cristal·lí, sense canviar de direcció, a més del raig primari o transmès que travessa la mostra, hi ha diversos electrons que es dispersen coherentment en certs angles i direccions de Bragg “amb direcció de Bragg”. La difracció d'electrons té la seva causa, entre altres coses, en la periodicitat o ordre de la xarxa cristal·lina, per la qual cosa l'estudi d'aquests electrons difractats proporcionarà una informació inestimable sobre l'estructura del material.
La figura 2 mostra l'ordenament atòmic de qualsevol estructura cristal·lina, sent l'espai entre plans “d”. El raig primari, amb longitud d'ona ?, incideix sobre aquests plans amb l'angle 9 i el raig secundari o difractat surt amb l'angle 29. Perquè es produeixi la difracció és necessari per tant complir la següent llei, que es denomina “equació de Bragg”:
n| = 2 d sincer

La diferència i relació entre la informació obtinguda amb la tècnica de difracció que no dóna imatge (la que dóna la imatge de punt) i la que proporciona imatges reals es pot entendre com:
Com es pot observar en la figura 3, cada feix d'electrons distribuïts per difracció genera un punt en el pla focal de la lent, concretament en el pla A. La imatge que formen tots els punts es diu imatge de difracció.
Si es continua el recorregut òptic dels raigs, es pot observar que mitjançant la combinació de raigs dels diferents feixos d'electrons difractats es crea la imatge en el pla B.
El contingut informatiu procedent tant de la imatge de difracció com de la imatge real ha de ser el mateix (tret que entre els plans A i B es col·loqui una obertura que doni lloc a una restricció d'informació, com s'esmentarà més endavant), però distribuït de manera diferent.


La figura de difracció recull la informació mitjana del total de la mostra. En la imatge real es recupera la distribució d'aquesta informació per punts.
En la pràctica, la tècnica de les imatges de difracció s'utilitza per a determinar l'estructura dels cristalls i la tècnica d'imatge per a conèixer amb detall la distribució de les característiques de la microestructura.
En la figura 4 es mostra la imatge real amb la seva corresponent imatge de difracció. Quan la imatge es genera amb el feix d'electrons no difractat, és a dir, amb el raig transmès, obtenim la imatge del Camp Clar:
D'acord amb l'orientació al raig agressiu de la mostra, en els drets definits fitats pels angles de Bragg, els feixos d'electrons que es difracturarán més o menys amb el diafragma o objectiu d'obertura (que forma un angle menor que l'angle difractat) establert en el pla focal de la lent objectiva (on es genera la imatge de difracció), només es pot veure la imatge transmesa per la columna (1). Això permetrà obtenir una imatge més contrastada.
Mitjançant el feix d'electrons que passa per l'objectiu d'obertura, la lent objectiva crea la primera imatge augmentada de la mostra. En aquest mateix pla se situa l'obertura central.
La lent central i les lents de projecció multipliquen per dues aquesta primera imatge. Igual que en l'òptica de llum, l'augment total es produeix pel producte dels augments produïts per les diferents lents. L'última imatge ampliada en tres ocasions es podrà veure en pantalla fluorescent i, si es desitja, imprimir en plaques fotogràfiques.
L'ampli camp d'ampliació s'obté amb diferents mesures d'excitació d'aquestes lents centrals.


En aquesta pantalla es visualitzarà en negre la zona de la mostra en la qual l'electró ha desviat àmpliament pel fet que aquests raigs no han deixat passar les obertures objectives i, per tant, s'ha eliminat gran intensitat del raig incident. En canvi, les zones que no han generat difracció, donaran un clar contrast.
Aquest tipus de contrast obtingut en la figura es coneix com a “contrast de difracció” o “contrast d'orientació” i, per tant, es genera amb diferents desviacions o difracció dels electrons que es deriven tant dels elements de la microestructura com dels defectes.
Les dislocacions, per exemple (quals són defectes de la microestructura), que tenen un ordenament no lineal (defectuós) dels àtoms, repel·leixen fortament els electrons des de la seva adreça d'atac, per la qual cosa els veurem com a línies fosques en la pantalla del microscopi (veure figura 5).
Com s'ha indicat, perquè els electrons travessin la mostra és necessari que la zona en qüestió sigui molt fina, és a dir, transparent als electrons. El gruix ideal oscil·la entre els 100Á i la micro.
Per tant, es preparen els “foils” de mostra de 3 mm de diàmetre i en el primer pas preparatori s'aprima fins a 100 ?m, obtenint-se després un gruix de ª 1 ?m tant per poliment electrolític com per atac del feix d'ions. El resultat és una petita discoteca perforada amb diverses zones molt primes al voltant del buit. Aquestes són les principals àrees d'estudi del microscopi.
La major contribució del T.E.M. és la de destacar els defectes cristalográficos que presenten els sòlids. En conseqüència, les propietats i el comportament d'aquests errors han pogut ser analitzats detalladament i les conclusions d'aquestes observacions han estat molt útils en la ciència dels materials.
En la figura 6 es mostra una altra fotografia de l'acer inoxidable Aisi 304 en T.E.M. amb la seva imatge de difracció.
En la figura 7 es mostra la comparació d'ampliacions i resolucions obtingudes mitjançant les tres tècniques esmentades.


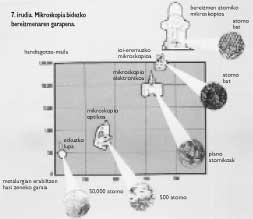
Buletina
Bidali zure helbide elektronikoa eta jaso asteroko buletina zure sarrera-ontzian











